El método actual de producción de chips de memoria de todo tipo es a través del apilamiento de chips más pequeños sobre una placa de circuito impreso (la PCB). A pesar de que esos chips se crean a su vez por apilamiento de capas de memoria unidas con vías a través del silicio (TSV), la unión de los chips con la PCB se hace mediante un más tradicional interconexión con hilos —que es como se unían hasta hace poco las capas de memoria en sí—.
Samsung ha avanzado en su tecnología de empaquetamiento de chips de memoria al permitir que los subchips también se conecten a la PCB mediante vías a través del silicio. Este nuevo sistema permite la unión de hasta doce chips de DRAM agujereados más de 60 000 veces en el mismo grosor de paquete de 720 µm, teniendo doce capas de memoria en lugar de ocho capas.
La ventaja de este empaquetamiento es que las líneas de comunicación son más cortas que benefician la latencia de comunicación, pero también resulta en chips de memoria DRAM más compactos. Eso permite que Samsung pueda ofrecer con este método de encapsulado unos chips de DRAM de 24 GB frente a los de 8 GB actuales.
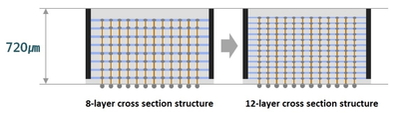
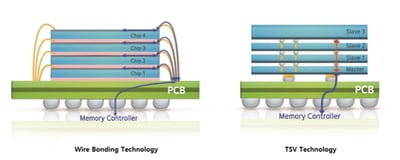
Vía: Samsung.