TSMC compite con Samsung en lo que a tecnologías de fabricación de chips se refiere, y uno de los métodos más interesantes que están preparando es el de oblea sobre oblea. Es un método de fabricación avanzado que permite apilar dos obleas de chips y unir los distintos chips mediante vías a través de silicio, creando así «chips 3D». No es que no tuvieran grosor antes, pero el concepto en este mundillo es que todo lo apilable es 3D, como la NAND 3D.
Esta tecnología la anunció el año pasado en Santa Clara (California), y la compañía ha hablado sobre sus progresos de este método de oblea sobre oblea —WoW, de wafer-on-wafer, no de World of Warcraft—. Según el director ejecutivo adjunto de TSMC, Wei Zhejia, estarán listos para la producción de chips con esta técnica en 2021.
Puesto que los chips están en el mismo empaquetado, esto permite escalar la potencia del procesador según el modelo específico que se cree. Con ello quiero decir que, por ejemplo, si AMD —la más interesada en ello— crea un chip para sus unidades de procesamiento gráfico (GPU), podría decirle a TSMC que interconecte con esas vías a través del silicio dos obleas, tres obleas o más, creando pilas de dos, tres o cuatro chips. De cara al sistema operativo se verían como un único procesador, lo cual es una ventaja para las unidades centrales de procesamiento (CPU).
Otro uso que se le puede dar y que abarata el proceso de empaquetamiento de los chips es crear una oblea con chíplets que incluyan solo los núcleos de procesamiento —como los que va a usar AMD con los Ryzen 3000, los de arquitectura Zen 2— y unirle chips de otra oblea que contengan la lógica e interconexión externa (E/S, PCIe, etc.). Eso haría que el diseño actual de chíplets más chip de control para los Ryzen 3000 podría ocupar mucho menos espacio, y con la ventaja de poder apilar varios chíplets. En el entorno de los portátiles o incluso tabletas o móviles grandes se podrían crear procesadores muy potentes y muy pequeños.
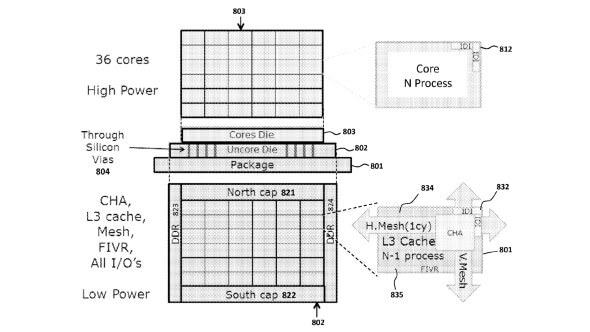
Vía: WCCFTech.